样品厚度是透射电镜(TEM)成像中的重要参数,主要用于图像衬度的解释以及性能和微观结构之间的关系的研究。当前,透射电镜中常用的样品测厚方法主要包括电子能量损失谱(EELS),会聚束电子衍射(CBED)和位置平均会聚束电子衍射 (PACBED)等技术。其中EELS是一种原位测厚技术,主要通过Log-ratio方法或K-K求和法则来计算样品的相对厚度或绝对厚度。在准确测得非弹性平均自由程的情况下,EELS测厚的准确度可达±10%。CBED测厚则主要借助模拟来实现,测厚准确度可达 ± 5%。PACBED是扫描透射模式(STEM)下的一种测厚方法,通过对多个位置的CBED花样取平均,最终获得的PACBED花样中只包含厚度、倾转和极化的影响,精确度由于± 10%。然而,实际使用时,EELS测厚需要昂贵的Gatan成像过滤系统(Gif),而CBED和PACBED测厚则需要复杂且耗时的模拟工作。
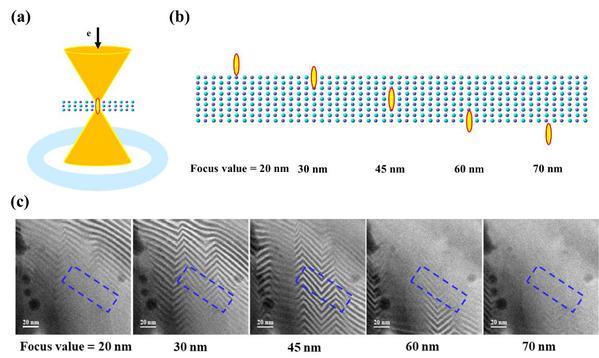
太阳成集团tyc234cc物质科学与信息技术研究院电镜中心葛炳辉教授团队在测定样品厚度方法的工作方面取得了最新成果,该成果以“Fast determination of sample thickness through scanning moiré fringes in scanning transmission electron microscopy”为题发表在《Micron》上,太阳成集团tyc234cc南鹏飞博士为第一作者,葛炳辉教授为通讯作者。文章介绍了一种STEM模式下快速测定样品厚度的方法,主要通过调节focus借助系列离焦的扫描莫尔条纹(SMF)成像来判断。通过将样品倾转至正带轴或强的双束衍射条件,并且适当调整放大倍数和电子束扫描方向就可以在中等放大倍数范围观察到SMF像。
通过SMF的形成条件可知,只有电子探针和样品发生相互作用时才能观察到SMF。再通过改变离焦量,就可以控制电子探针相对于样品的位置,从而实现SMF的出现和消失。因此,实际在改变离焦值时电子探针的位置变化∆f就反映了样品厚度。不过,要更准确的获得样品厚度T还需要考虑电子探针在深度方向的尺寸δZ 以及样品表面总的非晶层厚度(A), 即T=∆f-δZ+A,其中δZ=1.77λ/α2,α为会聚半角,λ为电子波长。进一步地,本工作还结合EELS测厚方法验证了SMF测厚方法的正确性。该工作强调了系列离焦SMF在快速测定样品厚度方面的应用,能够有效避免STEM模式下的电子束损伤和积碳问题,尤其适用于不耐电子束辐照的样品。
本工作受到国家自然科学基金项目(Nos. 11874394);安徽省高校协同创新计划项目 (No. GXXT-2020-003)的资助。



